IC芯片封装模流分析模拟仿真
服务内容:
金牌银牌顾问,IC芯片封装模流分析、金线偏移量分析、成型缺陷优化、UDB材料测试拟合、moldflow/moldex3d软件销售
应用价值:
IC芯片封装成型中常遇见的基板翘曲、金线变形分析、芯片偏移、充填困气、充填不满等诸多问题,都可以通过moldflow或者moldex3d模流分析软件来实现模拟IC芯片封装模流分析模拟仿真。
可预测的问题如下:
1.真实预测金线偏移量是否在公差内
2.预测金线密度对熔胶流动的影响
3.预测模型中每条金线的最大偏移指数值
4.预测晶垫偏移量是否在公差内
5.预测成形条件对产品翘曲变形的影响
6.精准仿真产品不同结构设计对翘曲变形之影响
7.预测基板材料对产品翘曲变形的影响
8.优化热固性材料成形条件与充填模式
9.预测射出压力与锁模力需求
10预测气孔与金线位置
应用案例( moldflow软件IC芯片封装模流分析):
IC芯片封装成型工艺简介:
热固性环氧树脂材料在IC组件塑料封装制程的充填过程中,高黏度熔胶以及快速流动可能会引起金线偏移问题。伴随金线偏移导致金线短路问题;在成型过程中,当金线变形或是和其他金线接触,即有可能会发生短路问题。
影响封装缺陷和失效的因素是多种多样的, 材料成分和属性、封装设计、环境条件和工艺参数等都会有所影响。确定影响因素和预防封装缺陷和失效的基本前提。影响因素可以通过试验或者模拟仿真的方法来确定,一般多采用物理模型法和数值参数法。对于更复杂的缺陷和失效机理,常常采用试差法确定关键的影响因素,但是这个方法需要较长的试验时间和设备修正,效率低、花费高。

IC芯片封装模流仿真——金线偏移量分析
1.结果如上图:通过moldflow模流分析软件模拟注塑充型过程,可以直观发现金线已经发生了偏移变形,且金线之间发生干涉情况。这是在IC芯片封装成型工艺要求中不能接受的严重问题。
2.另外,Moldex3D软件也有同样的金线偏移量分析功能,可以提供金线偏移预测以及金线偏移量,帮助使用者决定制程的参数设定、材料的选择以及导线架设计是否适当。
3.其存在一定的规律就是金线直径越小,金线偏移程度越大,金线离浇口位置越近,金线偏移程度越大,注塑保压压力越大偏移越严重。所以,这很考究参数设定、材料的选择以及导线架设计。
4.影响因素包括封装设计、引线布局、引线材料与尺寸、模塑料属性、引线键合工艺和封装工艺等。影响引线弯曲的引线参数包括引线直径、引线长度、引线断裂载荷和引线密度等等。
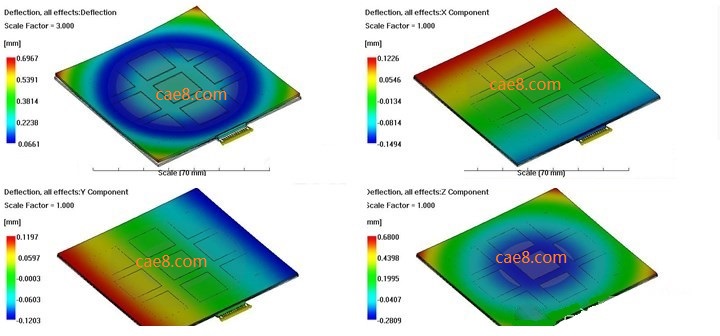
IC芯片封装模流分析仿真——封装基板整体翘曲变形(Warpage )
1.翘曲是指封装器件在平面外的弯曲和变形。因塑封工艺而引起的翘曲会导致如分层和芯片开裂等一系列的可靠性问题。翘曲也会导致一系列的制造问题,如在塑封球栅阵列(PBGA)器件中,翘曲会导致焊料球共面性差,使器件在组装到印刷电路板的回流焊过程中发生贴装问题。
2.影响偏移的因素包括塑封料的流动性、引线框架的组装设计以及塑封料和引线框架的材料属性。薄型小尺寸封装(TSOP)和薄型方形扁平封装(TQFP)等封装器件由于引线框架较薄,容易发生底座偏移和引脚变形。
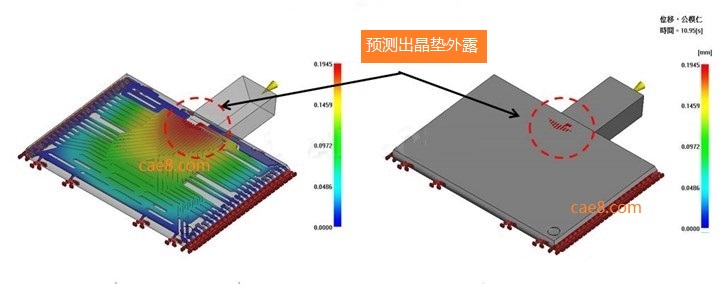
IC芯片封装模流分析仿真——注塑过程中晶垫偏移外露分析,

IC芯片封装模流分析仿真——封装注塑过程中困气状况分析
1.填模仿真分析认为,是底部熔体前沿与芯片接触,导致了流动性受到阻碍。部分熔体前沿向上流动并通过芯片外围的大开口区域填充半模顶部。新形成的熔体前沿和吸附的熔体前沿进入半模顶部区域,从而形成起泡。
2.封装工艺中,气泡嵌入环氧材料中形成了空洞,空洞可以发生在封装工艺过程中的任意阶段,包括转移成型、填充、灌封和塑封料至于空气环境下的印刷。通过最小化空气量,如排空或者抽真空,可以减少空洞。有报道采用的真空压力范围为1~300Torr(一个大气压为760Torr)。
3.电子器件是一个非常复杂的系统,其封装过程的缺陷和失效也是非常复杂的。因此,研究封装缺陷和失效需要对封装过程有一个系统性的了解,这样才能从多个角度去分析缺陷产生的原因。
moldex3d软件芯片封装模块

芯片封装模块目前支持的分析项目相当完善,除了基础的流动充填与硬化过程模拟;并延伸到其他先进制造评估,例如:金线偏移、芯片偏移、填充料比例、底部填充封装、后熟化过程、应力分布与结构变形等。透过精准的模拟可以预测及解决重大成型问题,将有助于产品质量提升,更可以有效地预防潜在缺陷;藉由优化达到优化设计,并缩减制造成本和周期。
核心优势:
1、正版moldex3D/moldflow模流分析软件,结果精准可靠。
最新求解算法、最新材料库属性、全面结果输出。数值化制造技术指导制造的时代势不可挡。通过模流分析验证模具设计方案的合理性,以及产品结构设计合理性,大大降低缺料、困气、缩痕、开裂、变形等成型缺陷,为您提升制品的品质,降低制造成本,数值化制造技术提升您企业的市场竞争力。
2、金牌顾问师带队,开业经营十余载,产学研实践应用经验丰富。
金牌顾问师带队熟悉上汽、北汽、广汽、长安、通用、宝马、特斯拉等主机厂高精度、高要求标准规范。给客户提供的不仅只是“模流分析报告”, 是能够指导生产的有力理论数据依据。
3、CAD/CAE/CAM产品链齐全,为您提供一站式的协同开发。
从产品端设计与分析,再到模具成型端设计与分析,各领域专家很好的衔接各个环节,全局考量各个环节。
4、十万级高端服务器,高效率完成订单,满足各层次交期需求。
为满足日益加快的研发周期,公司特配备高端硬件+经验丰富的专家+最新版本软件求解软件=高效作业。
5、收费诚信合理,以顾客需求为导向,为每一位顾客制定推荐最适合的产品方案。
好产品自然贵,但不一定最适合,以顾客需求为导向,为每一位顾客制定推荐最适合的产品方案。诚信为重,品质至上,用心服务,赢得信赖。
收费方式:

联系咨询,探索科学铸造方案,一起创造更高附加值
乐图智造科技,产品性能优化,有限元分析工程服务,软件销售,为制造业提供科学的数值信息化技术解决方案,
申明:本文原创自乐图智造官网,转载请注明出处。
查看更多案例: IC芯片封装分析 橡胶/硅胶模流分析 重力铸造模拟分析 压铸模流分析 MAGMA分析模拟 跌落分析 疲劳分析 CFD分析

乐图智造科技(苏州)有限公司
199 4191 2022
业务咨询/技术咨询/交流建议
扫码微信咨询,24小时期待你的声音

